導熱復合材料發展現狀
一、概況
導熱材料是一種新型工業材料,主要用于設備的熱傳導。這些材料性能優異、可靠,適合各種環境和要求,對可能出現的導熱問題都有妥善的對策。它們對設備的高度集成,以及超小超薄提供了有力的幫助。該導熱產品已經越來越多的應用到許多產品中,提高了產品的可靠性。
導熱材料的主要種類包括石墨烯、導熱粘合劑、石墨烯制備設備、導熱測試儀、加熱元件、導熱硅膠片、導熱絕緣材料、導熱界面材料、導熱矽膠布、導熱膠帶、導熱硅脂、導熱膏、散熱膏、散熱硅脂、散熱油、散熱膜和導熱膜等。
高導熱金屬基復合材料結合了金屬材料和無機非金屬材料的性能,表現出高熱導率、高強度、低密度和熱膨脹系數可調等綜合優勢,有望解決未來高性能電子器件的熱管理難題,未來10年或可大規模應用于電力電子、微波通信、軌道交通和航空航天等領域。
高導熱高分子基復合材料,相比于金屬、無機非金屬等傳統材料,高分子材料具有質量輕、成本低、機械性能好、耐腐蝕性強等突出優勢,因此可以在微電子器件、電子儲能和電子封裝材料等領域中替代傳統材料,并且在發光二極管、柔性可穿戴電子設備及新能源汽車等新興領域同樣需要大量的導熱高分子復合材料。
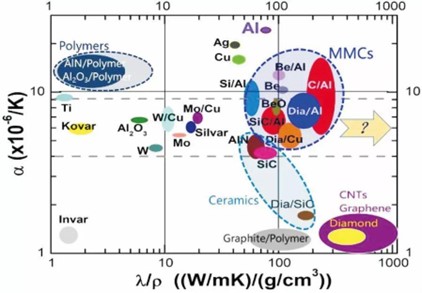
二、產業鏈
導熱材料產業鏈上游為原材料供應,主要包括石墨、PI膜、硅橡膠、塑料粒等化工原材料。這些原材料大部分都能通過市場化采購獲得,市場供應充足,不存在稀缺性。中游為導熱材料生產,中游的導熱材料生產企業是產業鏈的核心環節。這些企業利用上游原材料,通過一系列的加工工藝,生產出各種類型的導熱材料,如導熱硅膠片、導熱膠帶、導熱硅脂等。導熱材料產業鏈下游主要應用于消費電子、通信基站、動力電池等領域。其中,計算機是導熱材料下游占比最重的領域,占比達到32%。此外,可再生能源、電信、指示燈、醫療辦公設備、工業和軍事以及汽車等領域也有廣泛應用。

國際市場上,導熱材料行業已經形成了相對比較穩定的市場競爭格局,主要由國外的幾家知名廠家壟斷,導熱材料壟斷企業是美國Bergquist和英國Laird,其中合成石墨產品的市場主要由日本Panasonic、中石科技和碳元科技支撐。
國內市場上,由于中國導熱材料領域起步較晚,在巨大的市場需求推動下,近年來生產企業的數量迅速增加,但絕大多數企業品種少,同質性強,技術含量不高,產品出貨標準良莠不齊,未形成產品的系列化和產業化,多在價格上開展激烈競爭。目前少數國內企業如中石科技等逐漸具備了自主研發和生產中高端產品的能力,已經形成自主品牌并在下游終端客戶中完成認證,近年在國際客戶的供應體系中扮演著越來越重要的角色。
三、應用場景
1、芯片
芯片中的導熱材料主要包括芯片內部導熱材料和芯片外部熱管理兩部分。內部和外部區別主要在于導熱材料是否封裝在芯片內部。芯片的內部導熱材料主要包括封裝基板、底填材料和 TIM 材料。芯片外部的導熱材料則根據使用不同芯片的設備而有所不同。一般而言,以被動散熱為主的智能手機和平板電腦中以石墨系材料(主要為合成石墨膜)和VC為主,配備主動散熱組件(風冷、水冷器件)的 PC和服務器等則以熱管、VC為主。
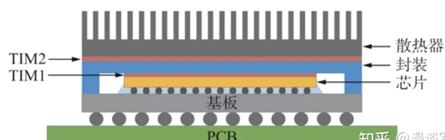
芯片內部的導熱材料分為頂部連接和底部連接部分。芯片底部需要與基板相連接,頂部需要與封裝殼相連接。在整個芯片封裝過程中,這些縫隙位置出現的空氣都可能會導致傳熱性能的急劇下降,因此頂部和底部都需要合適的 TIM 材料以滿足芯片-封裝蓋和芯片基板-PCB板的兩部分傳熱需求。
底部連接材料目前以環氧樹脂基材料為主。底部填充材料一般為了填充芯片和基板連接的焊球間的縫隙(芯片用焊球與基板相連)。在其它各類 TIM 材料中,硅樹脂是主流的基體,在芯片的底部填充用的底部填充膠中,主流工藝為二氧化硅填充的環氧樹脂。選用環氧樹脂基填充膠的原因主要是環氧樹脂的熱固性,生產過程方便。
常用的頂部連接材料為硅脂和無機相變金屬材料(銦居多)。頂部導熱一般是為了填充芯片與封裝所用的封裝外殼之間的空隙部分。芯片中所使用的灌封膠和頂部包封膠包括聚氨酯、環氧樹脂和硅橡膠或凝膠等。目前芯片中所使用的頂部填充大多數為硅脂。硅脂的優點在于使用簡便,只要將其涂膜在裸芯片的頂部,并且安置上封裝外殼即可。目前,在一些高端 PC 的 CPU 中也有使用無機相變材料作為頂部連接材料。
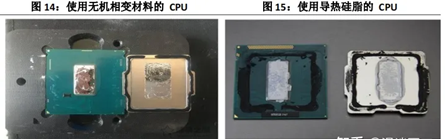
芯片外部的導熱材料主要為均熱材料和 TIM 材料,不同用途的芯片所采用的散熱途徑各不相同。產熱量較大的設備多采用被動傳熱+主動散熱的模式,所使用的均熱材料主要為熱管、均熱板,TIM 材料一般選用硅脂或相變金屬。產熱量較小的設備一般不配備主動散熱裝置,所使用的均熱材料多為石墨系材料與均熱板,TIM 材料一般選用硅脂或硅膠片。
智能手機、平板電腦等無主動散熱的設備中,多使用石墨系材料/均熱板+硅脂/硅膠片的組合。目前大部分的主流安卓智能手機和平板中使用均熱板作為散熱元件,均熱板和芯片元件中的空隙用硅脂填充。蘋果公司的手機和平板產品由于軟硬件構架適配性較高,目前最新產品仍舊使用合成石膜+硅脂作為芯片外導熱結構,尚未使用均熱板。

PC、服務器、計算中心和基站等能耗較大需要進行主動散熱的設備中,熱管+硅脂是首選的芯片外導熱材料。由于這些設備的性能要求較高,往往配備了風冷/水冷等散熱模塊,均熱/導熱段的主要作用是將熱傳導至散熱模塊處,由熱風/熱水將熱量帶出。因此 5G 基站需要導熱材料的導熱系數需要接近 10W/m·K,計算中心和基站則可能更高。在這樣的需求驅動下,大部分需要主動散熱的設備都選擇熱管實現熱量的定向傳導,并以硅脂填充縫隙。少部分高端 PC 和最新型的基站也有選用VC/相變金屬作為導熱材料。
3、汽車電子
電池系統中的導熱材料主要為聚氨酯導熱結構膠。動力電池行業所選的導熱膠不僅需要導熱性能符合需求,還需要對再粘接性能、輕量化、低成本甚至揮發性等方面進行綜合考量,因此其導熱性能往往維持在1.2-2.0 W/m·K范圍內。電池廠商在導熱膠需求量大且不斷降本的趨勢下,無法選擇高導熱(>3.0W/m·K)的有機硅產品,因此粘接強度、經濟成本具有優勢的聚氨酯導熱結構膠成為了眾多電池廠的選擇。
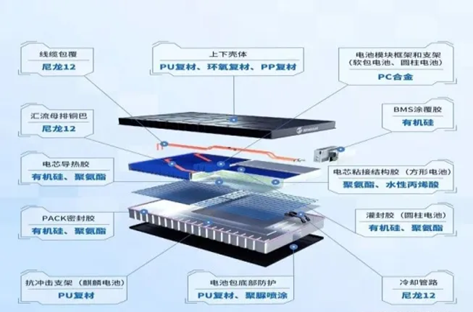
導熱硅膠為片狀固體,一般用于發熱量較小的電子零件和芯片表面,也廣泛用于動力電池組。導熱硅膠可涂覆于各種電子產品,電器設備中的發熱體與散熱設施(散熱片、散熱條、殼體等)之間的接觸面,起傳熱媒介作用和防潮、防塵、防腐蝕、防震等性能。目前的導熱硅膠的增量主要是在動力電池的電芯中,用于連接電池組。

目前,導熱材料行業有以下幾大壁壘:
導熱材料關鍵技術仍然處于空缺狀態,國家鼓勵行業發展。導熱材料是提高電子產品運行可靠性的關鍵元件,其核心環節的確可能對未來電子產品行業發展形成不確定因素。近年來,國務院、發改委及各主管部門相繼出臺的一系列行業發展政策、規劃、指導意見,給予電子行業及其上下游產業的支持。



重點企業

隨著移動通信技術的進步和信息化建設的不斷推進,電子產業實現了高增長的發展態勢,內部元器件結構逐漸精密化、集成化,電子設備硬件配置越來越高,因此提出更高的熱管理防護性能要求,推動熱管理材料產品種類不斷豐富,材料性能和加工工藝進一步升級。
由于不同的電子產品內部設計具有一定差異,不同終端廠商對熱管理材料往往有獨特的性能乃至特定的外型需求,因此在設計階段往往要求供應鏈企業能夠進行全方位的分析,為客戶提供高效且個性化的熱管理解決方案,這將極大地促進熱管理材料的持續創新和性能提升,從而提升行業產品整體的附加值水平。
隨著電子產品功能逐漸增加,內部結構更加復雜,產品內部功率密度加大,對人工合成石墨散熱膜的性能提出了更高要求。超厚型或多層復合人工合成石墨散熱膜依托于石墨膜的高導熱系數,通過增加厚度或設計多層結構疊合,提高整體或者局部厚度,大幅度加大熱量傳遞方向的熱通量,具有高效散熱性、易于加工等特性,能夠滿足復雜環境下對于電子產品的散熱需求,未來將逐漸替代現有薄的或單層結構產品。
隨著電子產品散熱技術的不斷發展,市場中的散熱解決方案日趨多樣。為增強散熱效果,多種散熱組件構成的散熱模組將取代單一散熱材料成為市場主流。以智能手機市場為例,人工合成石墨散熱膜未來將作為基礎性導熱材料,與均熱板、熱管等組件形成具備更高效散熱性能的多材料散熱方案。
上一篇:連續纖維復合材料的快速成型制造
下一篇:碳纖維復合材料的主要成型方法
相關內容
點擊排行
- 106-12一文帶你了解復合材料:復合材料的種類、加工及應用
- 212-07高性能纖維——芳綸纖維(概述篇)
- 301-29一文了解超高分子量聚乙烯纖維(上篇)
- 410-29聚焦聚酰亞胺:聚酰亞胺纖維、復合材料性能優異,前景廣闊(一)
- 511-28無人機發展現狀及未來展望(下篇)
- 602-27超高分子量聚乙烯(UHMWPE)材料的最新應用與未來展望
- 709-08聚雙環戊二烯(PDCPD)市場廣闊 其復合材料應用領域廣泛
- 801-26“黃金薄膜”聚酰亞胺(PI)技術與市場分析
- 903-07新型散熱材料——石墨烯高導熱材料
- 1012-11高性能纖維——芳綸纖維(制備方法與應用篇)
文章歸檔
評論排行榜
- “黃金薄膜”聚酰亞胺(PI)技術與市場分析
- 可持續玄武巖纖維增強PA 6,6復合材料:纖維長度和纖維含量對機械性能的影響(下)
- 不同聚合物及其復合材料回收再利用技術的發展趨勢(一)
- 中國復合材料工業協會年會暨四十周年紀念大會
- [直播預告]中復碳芯副總經理王志偉分享拉擠大梁板在風電中的應用及發展方向
- 喜訊:冀中新材第二條生產線首個產品亮相
- 東麗復合材料美國公司將把Torayca T1100的產能提高一倍